
半導體工藝技術的路線發展,無論是在存儲技術的途徑上,朝著 3D NAND 和 DRAM 前進,或是往邏輯器件的 FinFET 和 GAA(Gate-All-Around)結構邁進,工藝技術越先進,對於晶圓缺陷檢測與控制的技術要求越高。
晶圓缺陷檢測技術分為光學和電子束技術。傳統檢測技術是以光學檢測為主,透過光學原理可以很快地大範圍檢測。然而,隨著半導體制程不斷往下微縮,光學檢測在先進工藝技術的圖像識別的靈敏度明顯遞減,因此給了電子束檢測技術一個大顯身手的機會。
相較於光學檢測技術,電子束檢測技術的優勢是靈敏度高,但檢測的速度較慢。
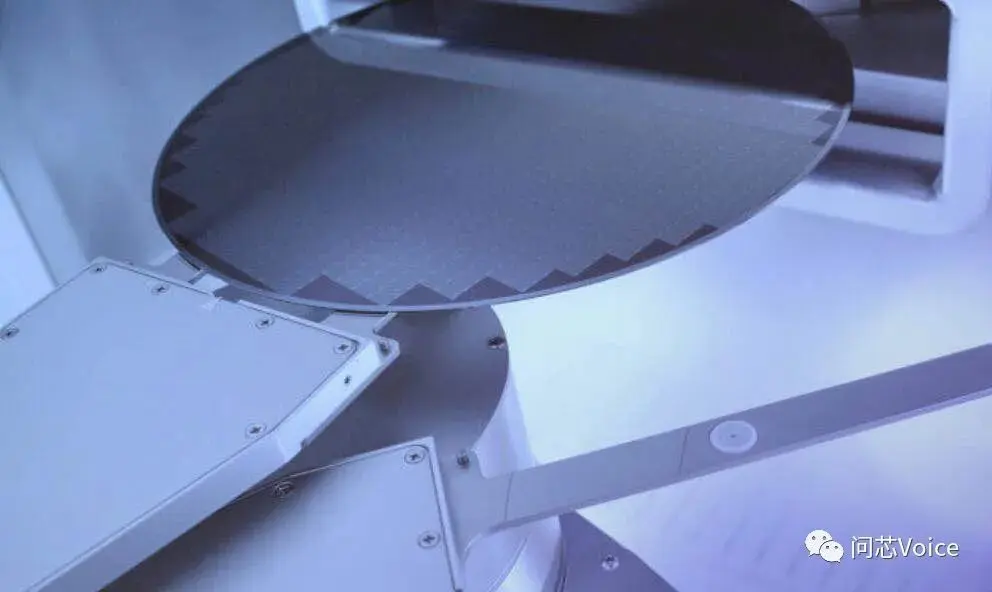
電子束的原理,是利用電子束掃描待測元件,得到二次電子成像的影像,通過對二次電子的收集,以呈現的圖像來解析晶圓在製程中的異常處。電子束檢測的優勢,是比較不受某些表面物理性質的影響,且可以檢測很小的表面缺陷,如柵極刻蝕殘留物等。
因此,現在針對先進製程芯片的生產流程,會同時使用光學檢測與電子束檢兩種技術,來互相輔助,進而快速找到晶圓生產的缺陷並控制和改善。尤其,也追求能即時檢測出缺陷,且儘可能在線上檢測並進行控制。
光學檢測和電子束檢測的配合流程,是當光學檢測系統在線上檢測到缺陷後,會用電子束再去檢視,重訪已檢測到的缺陷,並採用高分辨率圖像收集、提取,以及先進的機器學習算法對缺陷進行分析和分類。
這也是光學檢測系統和電子束檢測系統互相配合的優勢,可以即使的找出缺陷問題,並進一步提升晶圓廠在先進製程上的良率和學習曲線。
身為全球晶圓檢測技術龍頭的科磊 KLA 指出,無論是三維器件結構 3D NAND 和 DRAM,或是用於邏輯器件的 FinFET 和 GAA(Gate-All-Around)結構,晶圓廠都十分重視傳統的缺陷控制策略。
KLA 日前提出革命性的 eSL10 電子束圖案化晶圓缺陷檢查系統,且該系統也導入深度學習算法,將人工智能系統運用於其中。
KLA 指出,eSL10 的研發是始於最基本的構架,針對研發生產存在多年的問題來尋求突破口,可提供高分辨率、高速檢測功能,是目前市場上任何其他電子束系統都難以比擬的。
KLA 近一步指出,該技術可以輔助極紫外線(EUV)光刻技術的芯片,因為它能檢測出常規光學或其他電子束檢測平臺無法捕獲的缺陷。
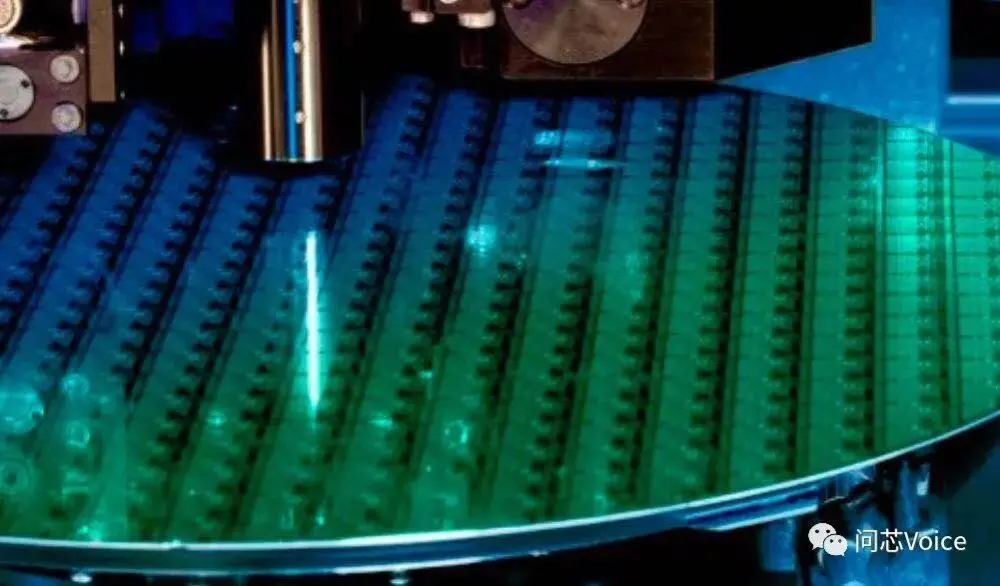
eSL10 電子束檢測系統能彌補對關鍵缺陷檢測能力的差距,其獨特的電子光學設計提供了在業界相對比較廣泛的操作運行範圍,能夠捕獲各種不同製程層和器件類型中的缺陷。
再者,KLA 提出Yellowstone 掃描模式每次可以掃描收集 100 億像素的信息,支持高速運行的同時,並不會影響分辨率,以在較大區域內也能高效地研究潛在弱點,實現缺陷發現。
另外,Simul-6 傳感器技術可以通過一次掃描,同時收集表面、形貌、材料對比度和深溝槽信息,從而減少具有挑戰性的器件結構和材料中,識別不同缺陷類型所需的時間。
KLA 電子束部門總經理 Amir Azordegan 表示,利用單一的高能量電子束,eSL10 系統將電子束檢測性能提升到了一個新水平。在此之前,電子束檢測系統不能兼顧靈敏度和產能,嚴重限制了實際的應用。
經過採用全新的方法來設計電子束的架構和算法,eSL10 系統可以解決現有設備無法解決的問題。再者,目前 KLA 也將電子束檢測列入對製造尖端產品至關重要的設備清單。
KLA 指出,eSL10 與 KLA 的旗艦款寬光譜晶圓缺陷檢測系統的結合,可以為先進的芯片技術提供強大的缺陷發現和監測解決方案,在晶圓製造過程中,通過系統共同合作,可以更快地發現關鍵缺陷,解決從研發到生產的缺陷問題。
再者,eSL10 系統平臺也具有獨特的擴展性,可以延申到整個電子束檢測和量測應用,包括全球先進的邏輯器件、存儲器和製程設備製造商已經在使用 eSL10 系統。
轉載請超鏈接註明:頭條資訊 » KLA突破電子束晶圓缺陷檢測瓶頸,將助EUV光刻機一臂之力
免責聲明
:非本網註明原創的信息,皆為程序自動獲取互聯網,目的在於傳遞更多信息,並不代表本網贊同其觀點和對其真實性負責;如此頁面有侵犯到您的權益,請給站長發送郵件,並提供相關證明(版權證明、身份證正反面、侵權鏈接),站長將在收到郵件24小時內刪除。